Dünnschicht-Interferenzeffekte
Während des Fotolithografieprozesses können Interferenzeffekte bei dünnen Schichten die Oberflächeneigenschaften eines Substrats beeinflussen. Zu den üblichen Interferenzeffekten gehören der Stehwelleneffekt, reflektierende Kerben, Randwulstbildung und Unter- bzw. Überbrennen. Die Ingenieure von Platypus Technologies haben unsere Standardbetriebsverfahren verbessert, um mögliche Defekte, die durch Dünnschicht-Interferenzeffekte verursacht werden, zu berücksichtigen.
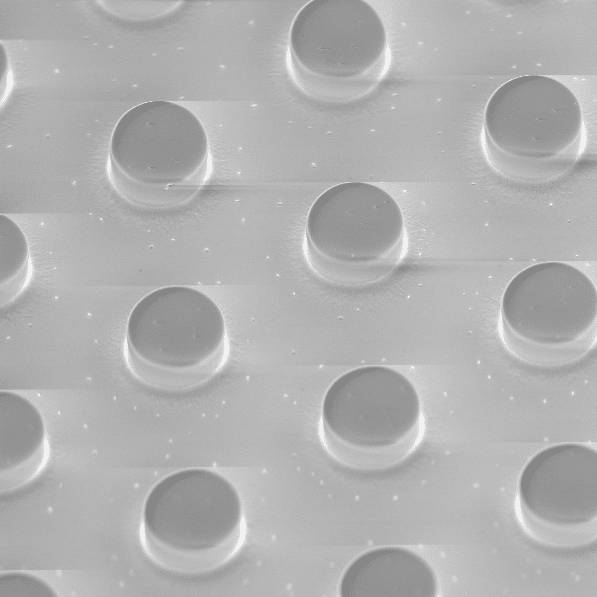
Ein Phänomen, das als der Effekt der stehenden Welle tritt auf, wenn das von einem Substrat reflektierte Licht mit einer sich nach unten bewegenden Lichtwelle interferiert, was zu einem kräuselnden Erscheinungsbild auf einem Fotolackmuster führt. Wenn eine Lichtwelle auf die Oberfläche eines Fotolacks trifft, wird das Licht entweder durchgelassen oder reflektiert. Die Amplitude einer stehenden Welle hängt vom Reflexionsvermögen des Substrats und der Absorption des Fotolacks ab. Die Stärke der stehenden Wellen kann durch Antireflexionsbeschichtungen und einen Nachbelichtungsprozess (Post-Exposure Bake, PEB) reduziert werden. Antireflexbeschichtungen haben eine hohe Absorption des einfallenden Lichts, was dazu beitragen kann, das Reflexionsvermögen an der Grenzfläche zwischen Substrat und Lack zu verringern. Die Wirksamkeit von Antireflexbeschichtungen hängt von ihrer Dicke ab, die je nach Fotolackdicke entweder erhöht oder verringert werden kann. Darüber hinaus kann die Bildung stehender Wellen durch Einbrennen nach der Belichtung verringert und beseitigt werden. Die hohen Temperaturen, die beim PEB verwendet werden, initiieren die Diffusion sowohl in den belichteten als auch in den unbelichteten Fotoprodukten innerhalb eines Fotolacks, wodurch eine gleichmäßigere Oberfläche entsteht.
Reflektierende Kerben können auch unerwünschte Bereiche belichtet werden, und es können unregelmäßige Muster entstehen. Dies ist häufig bei der Arbeit mit Aluminium der Fall, dessen reflektierende Oberflächeneigenschaften Interferenzeffekte verursachen. Eine Anpassung der Fotolackzusammensetzung kann dazu beitragen, reflektierende Kerben durch die Zugabe eines Farbstoffs zu verringern. Antireflexionsbeschichtungen tragen ebenfalls zur Verringerung von Reflexionen bei.
Randperlen können sich während der Schleuderbeschichtung aufgrund der Oberflächenspannung auf der Substratoberfläche ansammeln. Das Vorhandensein von Randwülsten führt zu Verunreinigungen, Waferbruch, längeren Bearbeitungszeiten und ungenauer Musterübertragung. Die Vermeidung von Randwülsten erfolgt durch die Berechnung geeigneter Schleudergeschwindigkeiten auf der Grundlage der Viskosität des Photoresists. Chemische Randwulstentferner (EBR) können direkt auf den betroffenen Bereich eines Substrats aufgetragen werden, um die Verunreinigung wirksam zu entfernen.
Die weiches und hartes Backen Schritte im Fotolithografieprozess können die Haftung zwischen dem Fotolack und dem Substrat beeinträchtigen. Das Soft-Backing wird direkt nach der Schleuderbeschichtung durchgeführt. Hartes Einbrennen erfolgt in der Regel nach der UV-Belichtung. Eine Unterhärtung führt zu einer unzureichenden Haftung des Fotolacks auf dem Substrat, während eine Überhärtung zu Rissen und Ablösungen führen kann. Das Aufbringen einer Metallhaftungsschicht kann die Haftung zwischen Substrat und Metall verbessern. Eine kostengünstigere Lösung ist jedoch die UV-Ozon-Behandlung. Es hat sich gezeigt, dass UV-Ozon die Substrathaftung verbessert, indem es die Haftfestigkeit zwischen Metall und Substrat durch Bildung einer Monoschicht auf der Metalloberfläche erhöht [1]. Die Behandlung eines Substrats vor der Metallabscheidung kann die Oberflächenbenetzbarkeit und die Oberflächenrauhigkeit erhöhen, was zur Verbesserung der Metall-Substrat-Haftung beiträgt [1].
Die Ingenieure von Platypus Technologies haben mehrere QC-Experimente durchgeführt, um unsere Photolithographie Verarbeitung und Herstellung. Kontakt und erkundigen Sie sich noch heute nach unseren Fotolithografie-Dienstleistungen!
Ressourcen:
[1] Hai Le-The, Roald M. Tiggelaar, Erwin Berenschot, Albert van den Berg, Niels Tas, und Jan C. T. Eijkel. ACS Nano 2019 13 (6), 6782-6789. DOI: 10.1021/acsnano.9b01403